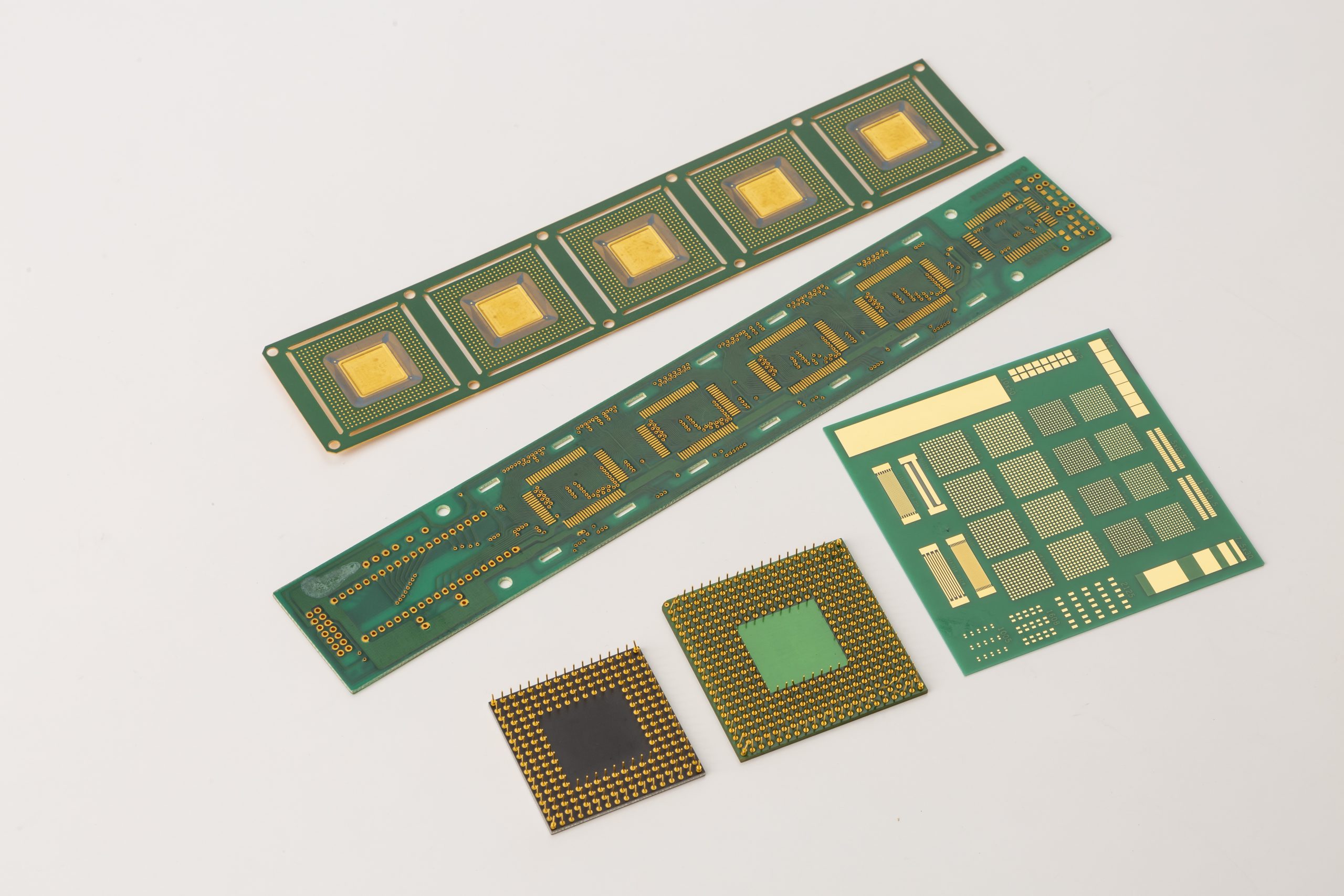
基板の金めっきの厚さの基礎知識を解説
基板における金めっきの厚さは、製品の用途や使用環境に応じて適切に設定する必要があります。
金めっきとは、表面に露出する回路の酸化防止や機能性の向上・付与を目的としておこなわれる表面処理です。耐食性や導電性が高い金の皮膜を析出することで、基板の信頼性を高めます。
皮膜を形成する際には、厚さのコントロールが重要です。めっきの厚さは、電気的な性能や基板との密着強度、耐摩耗性などに直結する要素であるためです。
以下では、基板への金めっきの厚さの考え方を詳しく解説します。
用途によって厚さが大きく異なる
プリント基板への金めっきの厚さは、使用用途によって大きく異なります。
たとえば、はんだ実装用パッドでは、酸化防止とはんだの濡れ性向上の確保が主な目的であり、0.03〜0.1µm程度の薄膜で十分です。
一方、頻繁に抜き差しされるコネクタ端子では、繰り返しの摩擦に耐えられるよう0.1〜1.5µm程度以上の厚みが求められることもあります。
基板と外部電源を接続するワイヤーボンディングでは、強度を確保するために0.5〜2µm程度の金めっきが施されることも多いです。
以上のように、接触頻度や強度の必要性などに応じて、求められる厚さは大きく変化します。
厚くすれば良いわけではない
基板への金めっきは、厚ければ良いというわけではありません。膜厚を厚くしすぎると、金の使用量が増えるため、コストが大幅に上がります。
コスト面だけでなく、はんだの接合強度にも金めっきの厚さは影響します。厚いめっきでは、はんだとの反応が進みすぎるため、接合界面が脆くなり、接合強度の低下につながりかねません。製品の信頼性に悪影響を及ぼすことがあるので、注意が必要です。
過剰な厚さは、必ずしも高品質に直結するわけでなく、むしろコストと性能のバランスを崩す要因になります。金めっきの厚さは、必要な性能を確保できる値に設定しましょう。
基板の金めっきの厚さを測定する方法
基板の金めっきの厚さを測定する主な方法は、以下のとおりです。
- 蛍光X線膜厚計
- 断面観察法
蛍光X線膜厚計は、非破壊でめっき厚さを測定できる手法です。基板にX線を照射し、発生するエネルギーの強度から膜厚を分析します。めっきの厚さが厚いほどX線の強度が高く、薄いほど低くなる原理を利用して測定されます。迅速に分析できるものの、破壊検査ほどの測定精度は得られません。
断面観察法は、基板の断面を直接観察し、金めっき厚さを直接計測する方法です。基板を樹脂に埋め込んだあと研磨し、光学顕微鏡や電子顕微鏡などを用いて観察します。微細な構造を高精度で評価できる一方、破壊検査である点がデメリットです。
蛍光X線膜厚計は生産現場の検査、断面観察は試作段階での使用に適しています。

めっき方法別の基板への金めっきの厚さ
基板へ金めっきを施す方法には、主に電解めっきと無電解めっきの2種類があります。両者は原理が異なり、それぞれで形成される皮膜の構造や厚さが異なります。
電解めっきは、金イオンを含む溶液に基板を浸漬し、電流を流すことで皮膜を析出する方式です。一方、無電解めっきは電流を流すことなく、薬品を使って化学反応によって皮膜を析出します。
どちらの方式を採用するかは、基板の使用用途やコストなどに応じてさまざまです。両者の特徴を理解することが、最適な表面処理選びのために大切です。
電解金めっきの厚さの特長
電解めっきは、厚付けでの皮膜の析出ができる点が特長です。成膜される標準的な厚さは0.1〜0.5μm程度であり、用途によっては1μm以上に達することもあります。なお、塚田理研では0.03μm~2.0μmまでの電解めっきに対応可能です。
電解めっきは、耐摩耗性や耐久性が求められる製品への表面処理に適しています。コネクタ端子など、頻繁に接触や摩擦が発生する用途に最適です。
ただし、電流の流れに影響されるため、膜厚が不均一になりやすい点がデメリットです。とくに複雑な形状の製品への処理には、適さないこともあります。
無電解めっきの厚さの特長
無電解めっきは、化学反応で皮膜を析出させる方法です。標準的な膜厚は0.01〜0.05μm程度であり、電解めっきよりも非常に薄い皮膜を形成できるという特長があります。なお、塚田理研では0.01μm~0.8μmまでの無電解めっきに対応可能です。
無電解めっきは、電流を使わずに化学反応でめっきを施すため、複雑な形状や微細な回路パターンにも均一に皮膜を析出できるという点がメリットです。また、薄膜でムラなく滑らかに仕上がることから、はんだ付け性にも優れています。
ただし、非常に薄い皮膜となるので、保管期限が短く、耐摩耗性や強度が劣る点には注意が必要です。
用途別の基板への金めっきの厚さの最適値
基板の設計や使用用途に応じて、金めっきの最適な厚さは、以下のように分類できます。
- はんだ実装パッド:0.03〜0.1µm程度
- ボンディング:0.5〜2µm程度
- コネクタ端子:0.1〜1.5µm程度
薄膜が適しているはんだ実装パッドでは、無電解金めっきが推奨されます。一方で、コネクタ端子などには、厚付けが可能な電解金めっきが適しているでしょう。
金めっきの最適な厚さは、対象の製品に要求される仕様とコストのバランスを鑑みて検討することが大切です。
なお、塚田理研では、0.01~0.08μmの極薄膜の金めっきの対応も可能です。基板への薄膜の金めっき処理をご希望の事業者様は、当社へご相談ください。

基板の金めっきの厚さに関するご相談は塚田理研まで
基板への金めっきの厚さは、用途によって調整する必要があります。適切な厚さは、製品の信頼性を高めるだけでなく、製品の寿命を延ばすことにもつながります。
塚田理研では、基板への金めっきの対応が可能です。最先端の設備、経験豊富な技術者が、お客様の製品一つひとつに最適な金めっきの厚さをご提案させていただきます。
必要に応じてニッケルなどの下地めっき処理もおこない、より高精度な仕上がりをご提供いたします。
基板への金めっきの依頼先にお悩みの事業者様は、以下フォームよりお気軽にお問い合わせください。
【お問い合わせ先】
本社:0265-82-3256
東京営業所:042-444-1287
刈谷オフィス:050-6868-2912
お問い合わせフォームはこちら
※個人のお客様からのご依頼は、ご要望に沿いかねます。
